
Mathematische Beschreibung des Bipolartransistors
Das physikalische Verhalten des Bipolartransistors basiert im Wesentlichen auf dem der Diode, wodurch die entsprechenden Formeln (in einer etwas abgewandelten Form) auch auf den Bipolartransistor angewandt werden können. Zusätzlich gilt es, einige weitere Effekte wie die Stromverstärkung zu berücksichtigen.
Formelzeichen
Im Folgenden werden die hier verwendeten Formelzeichen verwendet. Für weitere Formelzeichen siehe auch „Ersatzschaltungen des Bipolartransistors“.
Ströme
| -Strom | -Dauer- strom |
-Spitzen- strom | |
|---|---|---|---|
| Kollektor- | IC | ||
| Basis- | IB | ||
| Emitter- | IE |
- Sättigungssperrstrom:
- Kollektor-Basis-Sperrstrom:
- Emitter-Basis-Sperrstrom:
- Kollektor-Emitter-Sperrstrom:
bzw.
Spannungen
- Kollektor-Emitter Spannung:
- Basis-Emitter Spannung:
- Kollektor-Basis-Spannung:
- Early-Spannung:
- Emitter-Basis Durchbruchsspannung:
- Kollektor-Basis Durchbruchsspannung:
bei Niederspannungstransistoren
bei Hochspannungstransistoren
Widerstände
- Kleinsignalausgangswiderstand:
- Kleinsignaleingangswiderstand:
Leistungen
- Verlustleistung: PV
- Maximale Verlustleistung:
- Ptot oder Pmax (allgemein)
- PV,25(A) (Umgebungsluftgekühlt; bei 25 °C)
- PV,25(C) (mit zusätzlicher Kühlung; bei 25 °C)
Andere
- Großsignalverstärkung: B
bei Leistungstransistoren
bei Kleinleistungstransistoren
bei Darlington-Transistoren
- Kleinsignalverstärkung:
- Steilheit: S
- Rückwärtssteilheit:
- Arbeitspunkt: AP
- Umgebungstemperatur: TA
- Gehäusetemperatur: TC
Stromverstärkungsfaktor
Man unterscheidet beim Bipolartransistor
den Gleichstromverstärkungsfaktor B (auch )
und die differentielle Stromverstärkung β (auch
).
Beide können sehr unterschiedlich sein (je nach Aufbau und Dotierung des
Transistors). Sollten im Datenblatt
keine anderen Angaben zu β zu finden sein, kann man die Näherung
verwenden.
Die Formel für den Gleichstrom-Verstärkungsfaktor lautet:
Diese Formel kann für die meisten Berechnungen eingesetzt werden, da sich die
durch den Early-Effekt
verursachte Abhängigkeit des Gleichstromverstärkungsfaktors B von
nur geringfügig auswirkt.
Unter Berücksichtigung des Early-Effekts erhält man:
wobei
die ideale Stromverstärkung ohne Early-Effekt darstellt.
Bei Wechselstrom tritt die differenzielle Stromverstärkung auf. Diese ergibt sich aus:
mit
Durch Einsetzen erhält man den Zusammenhang zwischen B und β:
Man bezeichnet B auch als Großsignalverstärkung und
als Kleinsignalverstärkung.
Großsignalgleichungen
Über die Gleichungen der Diode zeigt sich eine exponentielle Abhängigkeit der
Ströme
und
von der Spannung
.
Für den Normalbetrieb ergibt sich somit:
Kleinsignalparameter
Die partiellen Ableitungen im Arbeitspunkt werden als Kleinsignalparameter bezeichnet. Diese können aus der Kennlinie ermittelt werden, allerdings ergibt sich aus dem Ablesefehler unter Verwendung von Datenblättern normalerweise kein brauchbares Ergebnis. Zudem sind die entsprechenden Kennlinien meist auch nicht angegeben.
Steilheit
Die Steilheit beschreibt die differenzielle Änderung des
Kollektorstromes
und der Spannung
.
Kleinsignaleingangswiderstand
Der Kleinsignaleingangswiderstand
beschreibt die differenzielle Änderung der Spannung
und mit dem Basistrom
.
kann durch eine Umwandlung dieser Formel auch aus der Steilheit abgeleitet
werden:
Kleinsignalausgangswiderstand
Der Kleinsignalausgangswiderstand
gibt die differenzielle Änderung zwischen der Emitterspannung
und dem Kollektorstrom
an.
Rückwärtssteilheit
Die Rückwärtssteilheit
beschreibt die differenzielle Änderung zwischen dem Basisstrom
und der Kollektor-Emitter-Spannung
.
Die Rückwärtssteilheit ist nur sehr gering und kann daher meist vernachlässigt werden.
Kleinsignalgleichungen
Aus den Kleinsignalparametern erhält man die Kleinsignalgleichungen:
Kühlung
Die Berechnung der Kühlung
eines Transistors entspringt der Wärmelehre.
Die entstehende Wärme in der Sperrschicht (junction)
muss über das Substrat an das Gehäuse (case) mit der Temperatur
,
danach über den Kühlkörper (heatsink) mit der Temperatur
und danach an die Umgebung (ambient) mit der Temperatur
abgeleitet werden. Der dabei entstehende Wärmestrom (Φ) entspricht
hierbei der im Transistor umgesetzten Leistung
.
Die in den einzelnen Körpern (Substrat, Gehäuse, Kühlkörper, Umgebung)
enthaltene Wärmemenge
ergibt sich aus:
Wobei
die Wärmekapazität der jeweiligen Körper darstellt, in der die Wärme gespeichert
wird. Wird im Transistor zu viel Leistung umgesetzt, kann die Wärme nicht
schnell genug abfließen und die Temperatur der einzelnen Schichten erhöht sich.
Zudem darf die Umgebungstemperatur nicht zu hoch sein, damit die Wärme abfließen
kann. Im Pulsbetrieb wird die maximale Leistung kurzfristig überschritten, da
jedoch die Schichten die Möglichkeit zur Abkühlung haben, wird die maximal
zulässige Temperatur dabei nicht überschritten.
Hierbei ist
die Pulsdauer,
die Wiederholfrequenz und D das Tastverhältnis.
Grenzdaten
Ein Transistor besitzt verschiedene Kenndaten, die im Betrieb nicht überschritten werden dürfen. Dazu gehören Grenzspannungen, Grenzströme und die maximal zulässige Verlustleistung. Werden diese Werte überschritten, tritt ein Durchbruch auf, bei dem das Halbleitermaterial im Transistor schmilzt und dadurch dauerhaft leitfähig wird bzw. verdampft. Wenn Halbleitermaterial verdampft, kann durch den entstehenden Gasdruck das Transistorgehäuse aufgesprengt werden. Die Werte von pnp- und npn-Transistoren unterscheiden sich im Vorzeichen, jedoch nicht in den Beträgen.
Die Bezeichnung der Durchbruchsspannungen und -ströme setzen sich zusammen aus dem jeweiligen Formelzeichen (Spannung = U; Strom = I), der Bezeichnung BR für Durchbruch (breakdown), der Angabe der Anschlüsse, auf die sich der Wert bezieht (C; B; E), und einem Zusatz, welcher für den Belastungstyp des Transistors steht.
| Zusatz | Bedeutung | Ausgang |
|---|---|---|
| S | shorted | kurzgeschlossen |
| O | offen; open | unbelastet |
| R | resistor | belastet |
Arbeitsbereich

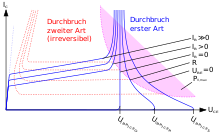

Ein Bipolartransistor hat einen Arbeitsbereich (engl.: SOA, Safe Operation Area), der im Wesentlichen durch folgende Größen begrenzt wird:
- maximal zulässiger Kollektorstrom
- maximale Kollektor-Emitterspannung
(Leerlauffall), auch als
bezeichnet
- maximale Sperrschichttemperatur
Da die Sperrschichttemperatur nicht direkt messbar ist, wird in Datenblättern
die maximale Verlustleistung
bei gegebener Umgebungs- bzw. Gehäusetemperatur angegeben.
Insbesondere bei Leistungstransistoren existiert noch eine weitere Grenze,
der Durchbruch
2. Art (engl.: second breakdown oder secondary
breakdown). Bei Leistungstransistoren hat das Halbleitermaterial
notwendigerweise ein größeres Volumen als z.B. bei
Kleinsignaltransistoren. Innerhalb des Halbleitermaterials treten daher vermehrt
Inhomogenitäten auf, was dazu führt, dass in einigen Volumenelementen eine
höhere Verlustleistung in Wärme umgesetzt wird als in anderen Volumenelementen.
Bei hinreichend großer Verlustleistung, die aber noch unterhalb des maximalen
Wertes
liegt, steigt in einigen Volumenelementen die Temperatur so weit an, dass das
Halbleitermaterial in den betroffenen Volumenelementen instabil wird. Bei
hinreichend großer Kollektor-Emitterspannung erfolgt in den betroffenen
Volumenelementen ein lokaler Durchbruch, wodurch diese zerstört werden. Durch
den Ausfall einzelner Volumenelemente steigen die Verlustleistung und damit die
Temperatur in allen anderen Volumenelementen an. Es erfolgen weitere lokale
Durchbrüche mit Zerstörung der betroffenen Volumenelemente. Der Effekt setzt
sich kaskadenartig fort und führt schließlich zur Zerstörung des
Halbleitermaterials.
Spannungen
- Basis-Emitter-Durchbruchsspannung
- Stellt die maximale Basis-Emitter Sperrspannung
dar und ist werkstoffabhängig. Bie Bipolartransistoren basierend auf Silicium liegt sie im Bereich um 5 V, bei Germanium nahe 20 V.
- Kollektor-Basis-Durchbruchsspannung
- Die Kollektor-Basis-Durchbruchsspannung
gibt an, wann die Kollektor-Diode im Sperrbetrieb durchbricht. Da die Kollektor-Diode im Normalbetrieb gesperrt sein muss, darf diese Spannung im Normalbetrieb nicht überschritten werden. Diese Spannung ist die größte Grenzspannung eines Transistors.
- Kollektor-Emitter-Spannung
- In der Praxis ist die maximale Kollektor-Emitter-Spannung
besonders wichtig. Ab einer bestimmten Kollektor-Emitter-Spannung tritt ein Durchbruch auf, durch den der Kollektorstrom sehr stark ansteigt und damit die Zerstörung des Transistors verursacht.
Allgemein gilt:
für npn-Transistoren (UBR > 0 V) und umgekehrt
für pnp-Transistoren (UBR < 0 V).
Ströme
Bei den Grenzströmen unterscheidet man zwischen den maximalen
Dauerströmen (continuous currents) und Spitzenströmen
(peak currents). Die maximalen Dauerströme werden ,
und
genannt. Die Spitzenströme werden
,
und
genannt und gelten jeweils für bestimmte, im Datenblatt angegebene, Pulsdauern
und Pulswiederholraten. Die Spitzenströme sind üblicherweise 1,2 bis 2 mal so
groß wie die Dauerströme.
Die Sperrströme (cut-off currents) werden mit
und
sowie mit
bzw.
bezeichnet. Diese Ströme treten an der Emitter- bzw. Kollektor-Diode auf, wenn
an dieser etwas weniger als die jeweiligen Diffusionsspannungen anliegen
(d.h. die Diode gerade nicht durchschaltet). Hierbei gilt:
Leistung
Die Verlustleistung des Transistors ergibt sich aus:
Die maximale Verlustleistung
bzw.
ist eine der wichtigsten Kenndaten eines Transistors. Die Temperatur in der Sperrschicht erhöht
sich um den Wert, bei dem die Wärme
über das Gehäuse und den Kühlkörper an die
Umgebung abgegeben werden kann. Diese Temperatur darf den materialabhängigen
Grenzwert nicht überschreiten. Für Silicium
gilt hierbei:
In der Praxis rechnet man hierbei sicherheitshalber mit einem Grenzwert von 150 °C, um ein vorzeitiges Schmelzen des Siliciums zu verhindern.
Im Datenblatt wird die maximale Verlustleistung für zwei Fälle angegeben:
- Umgebungsluftgekühlter (free-air cooled) Betrieb bei stehender
Montage auf einer Leiterplatte
bei einer Umgebungstemperatur (ambient temperature) von
. Bei Kleinleistungstransistoren ohne Befestigung für einen zusätzlichen Kühlkörper wird nur dieser Wert im Datenblatt angegeben, da in diesem Fall
gilt.
- Umgebungsluftgekühlter (free-air cooled) Betrieb bei stehender
Montage auf einer Leiterplatte
bei einer Umgebungstemperatur (ambient temperature) von
- Betrieb bei einer Gehäusetemperatur (case temperature) von
. Die notwendigen Kühlmaßnahmen werden hierbei meist nicht mit angegeben. Bei Leistungstransistoren, die nur mit einem Kühlkörper betrieben werden dürfen, wird nur dieser Wert im Datenblatt als
angeben.
- Betrieb bei einer Gehäusetemperatur (case temperature) von
Da die maximal zulässige Leistung
mit zunehmender Temperatur abnimmt, wird im Datenblatt oft die sog. power
derating curve angegeben, die
in Abhängigkeit von
bzw.
angibt.
Temperaturabhängigkeit
Die Kenndaten eines Transistors sind stark von der Temperatur des Transistors
abhängig. Die Abhängigkeit des Zusammenhangs zwischen Kollektorstrom
und Basis-Emitter-Spannung
von der Temperatur T ist hierbei besonders wichtig:
Der Grund dafür ist die Temperaturabhängigkeit vom Sperrstrom
und der Temperaturspannung
:
mit
Hierbei ist k die Boltzmannkonstante,
q die Elementarladung
und
die Bandabstandsspannung
von Silizium. Da die Temperaturabhängigkeit von UG nur sehr gering
ist, wird diese in der Praxis nicht berücksichtigt.
Durch Differentiation erhält man:
Das bedeutet, dass
bei einer Temperaturerhöhung von nur
bereits auf das 1,065-fache ansteigt. Zudem verdoppelt sich der Kollektorstrom
,
sobald die Temperatur um ca.
gestiegen ist. Der Arbeitspunkt kann daher nicht über
eingestellt werden, da
bei Temperaturänderung möglichst konstant gehalten werden muss.
Für den Fall, dass
nur schwach temperaturabhängig ist, kann man näherungsweise die
Temperaturabhängigkeit von
ermitteln:
Die Stromverstärkung ist ebenfalls temperaturabhängig. Hierbei gilt der Zusammenhang:
mit
Hierbei ist
eine vom Material abhängige Konstante. Bei Silicium gilt
.
In der Praxis ergibt sich bei T=300 K:
Und für die Näherung:
Vierpoldarstellung
Gemäß der Vierpoltheorie kann man jedes elektronische Bauelement als Vierpol behandeln. Im Fall des Transistors stellt man die Kleinsignalgleichungen in Matrizenform dar:
oder in der Leitwertdarstellung mit der Y-Matrix Ye:
Alternativ kann man auch die Hybrid-Darstellung mit der H-Matrix He verwenden:
Der Index e bedeutet hierbei, dass der Transistor in einer Emitterschaltung betrieben wird.
Für die Umwandlung gilt:

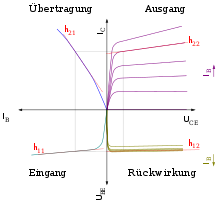
Hybrid-Ersatzschaltbild
Die h-Parameter können wie folgt ermittelt werden:
-
- Kurzschluss-Eingangsimpedanz bei
, bzw.
.
- Kurzschluss-Eingangsimpedanz bei
-
- Leerlauf-Spannungsrückwirkung bei
,
-
- Kurzschluss-Stromverstärkung bei
, wird in Datenblättern eher als
(Forward-Emitter) angegeben.
-
- Leerlauf-Ausgangsleitwert bei
.
-
Im Vierquadrantenkennlinienfeld können die Werte direkt aus den Diagrammen abgelesen werden.
Interpretation mithilfe der Kirchhoff'schen Gleichungen
Anwendung Emitterschaltung ohne Gegenkopplung
Der Emitter liegt in diesem Fall satt auf GND, der Kollektorwiderstand kann
im Kleinsignal-Ersatzschaltbild
auch nach GND gezeichnet werden und muss mit einem eventuell vorhandenen
Lastwiderstand parallelgeschaltet werden. Dieser Summenwiderstand wird als
bezeichnet. An diesem Widerstand liegt die Spannung
an, somit gilt
.
Die betriebliche Stromverstärkung kann mit Umformen der oben genannten Gleichungen berechnet werden:
Die betriebliche Spannungsverstärkung kann ebenfalls aus den oberen Gleichungen errechnet werden:
In gewisser Literatur wird noch die Vereinfachung
getroffen, somit:
Literatur
- Ulrich Tietze, Christoph Schenk: Halbleiter-Schaltungstechnik. 12. Auflage. Springer, 2002, ISBN 3-540-42849-6.


© biancahoegel.de
Datum der letzten Änderung: Jena, den: 19.04. 2023